華邦電子加入UCIe產業聯盟 支援標準化高性能chiplet介面
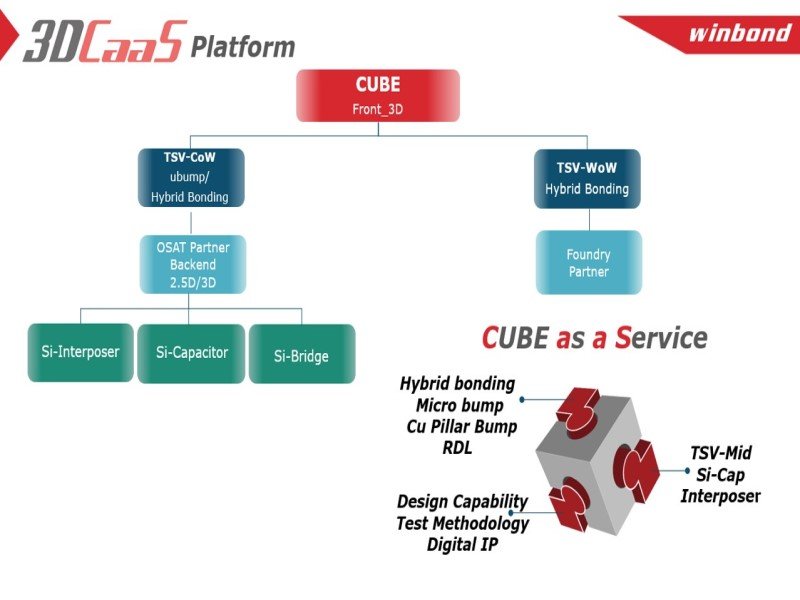 華邦電子加入UCIe產業聯盟 支援標準化高性能chiplet介面。(廠商提供)
華邦電子加入UCIe產業聯盟 支援標準化高性能chiplet介面。(廠商提供)
華邦電子今日宣佈正式加入UCIe™(Universal Chiplet Interconnect Express™)產業聯盟。結合自身豐富的先進封裝(2.5D/3D)經驗,華邦將積極參與UCIe產業聯盟,助力高性能chiplet介面標準的推廣與普及。UCIe產業聯盟聯合了諸多領先企業,致力於推廣UCIe開放標準,以實現封裝內芯粒間(chiplet)的互連,構建一個開放的Chiplet生態系統,同時也將有助於2.5D/3D先進封裝產品的開發。
華邦電表示,隨著5G、新能源車和高速運算等技術的飛速增長,業界對晶片制程與封裝技術的要求日益嚴格。如今,2.5D/3D多晶片封裝可實現晶片性能、能效和小型化的指數級提升,已經成為行業聚焦的主流趨勢。作為高性能記憶體晶片的行業領導者,華邦的創新產品CUBE: 3D TSV DRAM產品可提供極高頻寬低功耗,確保2.5D/3D 多晶片封裝的能效,並且為客戶提供優質的客製化記憶體解決方案。
加入UCIe聯盟後,華邦可協助系統單晶片客戶(SoC)設計與2.5D/3D後段工藝(BEOL, back-end-of-life)封裝連結。UCIe 1.0規範通過採用高頻寬記憶體介面來提供完整且標準化的晶片間互連環境,促進SoC到記憶體間的互連升級,以實現低延遲、低功耗和高性能。總體而言,標準化將助力加速推出高性能產品,為設備製造商和終端使用者帶來更高價值,從而推動先進多晶片引擎的市場增長。
不僅如此,加入UCIe聯盟後,華邦提供3DCaaS(3D CUBE as a Service)一站式服務平臺,為客戶提供最佳的標準化產品解決方案。此平台夥伴可提共客戶技術諮詢服務外,3DCaaS平臺還包括了3D TSV DRAM(又名CUBE)KGD記憶體晶片和針對多晶片設備優化的2.5D/3D 後段工藝(採用CoW/WoW技術)等相關服務。客戶可輕鬆獲得完整且全面的CUBE產品支援,並享受Silicon-Cap、interposer等技術的附加服務。
華邦電子DRAM產品事業群副總范祥雲表示:「2.5D/3D封裝技術可進一步提升晶片性能並滿足前沿數位服務的嚴格要求,而隨著UCIe規範的普及,我們相信這項技術將在雲端到邊緣端的人工智慧應用中充分發揮潛力,扮演更加重要的角色。」
UCIe聯盟主席Debendra Das Sharma博士表示:「作為全球記憶體解決方案的知名供應商,華邦電子在3D DRAM領域擁有堅實的專業知識,因此我們十分歡迎華邦的加入,並期待華邦為進一步發展UCIe生態做出貢獻。」
